Sumber:https://link.springer.com/chapter/10.1007/978-3-319-48933-9_13
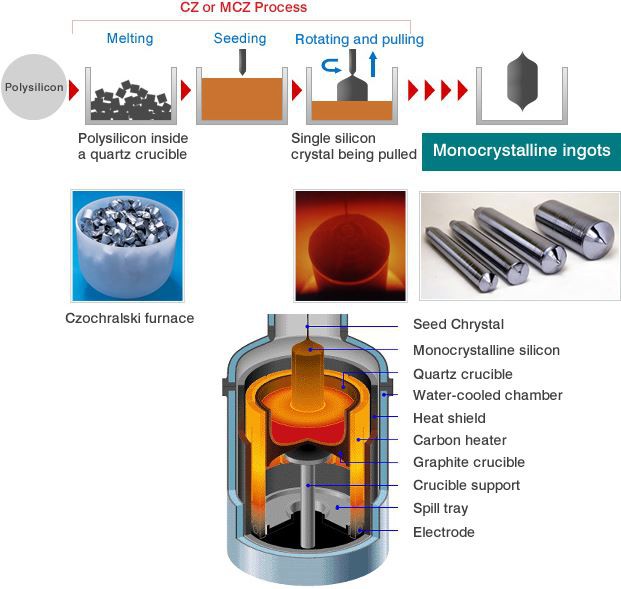
Silikon, yang telah dan akan terus menjadi bahan dominan dalam industri semikonduktor untuk beberapa waktu akan datang [13.1], akan membawa kita ke era integrasi skala besar (ULSI) dan era sistem-ona-chip (SOC).
Oleh kerana alat elektronik menjadi lebih maju, prestasi peranti menjadi lebih sensitif terhadap kualiti dan sifat bahan yang digunakan untuk membuatnya.
Germanium (Ge) pada asalnya digunakan sebagai bahan konduktor untuk peranti elektronik keadaan pepejal. Walau bagaimanapun, jurang sempit (0,66 eV) Ge menghadkan operasi peranti berasaskan germanium hingga suhu sekitar 90∘C kerana arus kebocoran yang ketara diperhatikan pada suhu yang lebih tinggi. Jalur silikon yang lebih luas (1.12 eV), sebaliknya, menghasilkan alat elektronik yang mampu beroperasi hingga. Walau bagaimanapun, terdapat masalah yang lebih serius daripada jurang sempit: germanium tidak mudah memberikan lapisan pasivasi yang dapat dilihat di permukaan. Contohnya, germanium dioksida (GeO2larut dalam air dan berpisah pada kira-kira 800∘C. Silikon, berbeza dengan germanium, dengan mudah mengakomodasi pasivasi permukaan dengan membentuk silikon dioksida (SiO2), yang memberikan tahap perlindungan yang tinggi kepada peranti yang mendasari. SiO yang stabil ini2lapisan menghasilkan kelebihan khusus untuk silikon berbanding germanium sebagai bahan semikonduktor asas yang digunakan untuk fabrikasi alat elektronik. Kelebihan ini membawa kepada banyak teknologi baru, termasuk proses penyebaran doping dan menentukan corak yang rumit. Kelebihan lain dari silikon adalah bahawa ia benar-benar tidak beracun, dan silika (SiO2, bahan mentah dari mana silikon diperoleh, terdiri lebih kurang 60%kandungan mineral kerak Bumi. Ini menunjukkan bahawa bahan mentah dari mana silikon diperoleh terdapat dalam banyak bekalan ke litar bersepadu (KAD PENGENALAN) industri. Lebih-lebih lagi, silikon gred elektronik dapat diperoleh dengan harga kurang dari sepersepuluh dari kos germanium. Semua kelebihan ini menyebabkan silikon menggantikan germanium sepenuhnya dalam industri semikonduktor.
Walaupun silikon bukanlah pilihan paling optimum untuk setiap peranti elektronik, kelebihannya bermaksud bahawa ia pasti akan menguasai industri semikonduktor untuk beberapa waktu.
Interaksi yang sangat berbuah telah berlaku antara pengguna dan pengeluar bahan semikonduktor sejak penemuan transistor titik kontak pada tahun 1947, ketika keperluan untuksempurna dan sucikristal dikenali. Persaingan seringkali sedemikian rupa sehingga kualiti kristal yang dituntut oleh peranti baru hanya dapat dipenuhi dengan mengawal pertumbuhan kristal menggunakan peralatan elektronik yang dibangun dengan perangkat baru ini. Sejak kristal silikon bebas dislokasi ditanam pada awal tahun 1960-an menggunakanTeknik sengkang[13.2], penyelidikan dan pengembangan bahan semikonduktor telah tertumpu pada kemurnian bahan, hasil pengeluaran, dan masalah yang berkaitan dengan pembuatan peranti. Gambar rajah aliran untuk proses penyediaan silikon semikonduktor khas. (Selepas [13.1]) Cip per wafer sebagai penghubung generasi DRAM. (Selepas [13.3]) Dalam bab ini, pendekatan terkini untuk penyediaan silikon - mengubah bahan mentah menjadi silikon kristal tunggal (lihat Gambar.13.1) - dibincangkan. Langkah seterusnya adalah membersihkan MG-Si ke tahap silikon gred semikonduktor (SG-Si), yang digunakan sebagai bahan permulaan untuk silikon kristal tunggal. Konsep asasnya adalah bahawa serbuk MG-Si direaksikan dengan HCl anhidrat untuk membentuk pelbagai sebatian klorosilana dalam reaktor tidur terfluid. Kemudian silan disucikan dengan penyulingan dan pemendapan wap kimia (CVD) untuk membentuk SG-polysilicon. 1. Ia dapat terbentuk dengan mudah oleh reaksi hidrogen klorida anhidrat dengan MG-Si pada suhu yang cukup rendah (200-400∘C). 2. Ini cair pada suhu bilik, sehingga pemurnian dapat dilakukan dengan menggunakan teknik penyulingan standard. 3. Ia senang dikendalikan dan boleh disimpan di dalam tangki keluli karbon apabila kering. 4. Trichlorosilane cair mudah diuap dan, apabila dicampurkan dengan hidrogen, ia dapat diangkut dalam garis keluli. 5. Ia dapat dikurangkan pada tekanan atmosfera dengan adanya hidrogen. 6. Pemendapannya dapat terjadi pada silikon yang dipanaskan, menghilangkan keperluan untuk bersentuhan dengan permukaan asing yang mungkin mencemarkan silikon yang dihasilkan. 7. Ia bertindak balas pada suhu yang lebih rendah (1000–1200∘C) dan pada kadar yang lebih pantas daripada silikon tetraklorida. Tidak perlu dikatakan, ketulenan batang langsing mesti setanding dengan ketebalan silikon. Batang nipis dipanaskan hingga kira-kira 400∘C pada permulaan proses CVD silikon. Pemanasan ini diperlukan untuk meningkatkan kekonduksian batang langsing dengan ketulenan tinggi (rintangan tinggi) dengan cukup untuk membolehkan pemanasan tahan. Penyetoran selama 200-300 jam sekitar jam 1100∘C menghasilkan batang polysilicon dengan kemurnian tinggi berdiameter 150–200 mm. Batang polysilicon dibentuk menjadi pelbagai bentuk untuk proses pertumbuhan kristal berikutnya, seperti potongan untuk pertumbuhan lebur Czochralski dan batang silinder panjang untuk pertumbuhan zon apungan. Proses untuk mengurangkan trichlorosilane pada batang silikon yang dipanaskan menggunakan hidrogen dijelaskan pada akhir 1950-an dan awal 1960-an dalam sejumlah paten proses yang diberikan kepada Siemens; oleh itu, proses ini sering disebutKaedah Siemens[13.4]. Kelemahan utama kaedah Siemens adalah kecekapan penukaran silikon dan klorin yang buruk, ukuran kumpulan yang agak kecil, dan penggunaan kuasa yang tinggi. Kecekapan penukaran silikon dan klorin yang lemah dikaitkan dengan jumlah besar tetraklorida silikon yang dihasilkan sebagai produk sampingan dalam proses CVD. Hanya sekitar 30%silikon yang disediakan dalam tindak balas CVD diubah menjadi polisilikon dengan kemurnian tinggi. Juga, kos menghasilkan polysilicon dengan kemurnian tinggi mungkin bergantung pada kegunaan produk sampingan, SiCl4. Teknologi pengeluaran Apolysilicon berdasarkan pengeluaran dan pirolisis monosilane telah dibentuk pada akhir tahun 1960-an. Monosilane berpotensi menjimatkan tenaga kerana mendapan polysilicon pada suhu yang lebih rendah dan menghasilkan polysilicon yang lebih tulen daripada proses trichlorosilane; namun, ia hampir tidak dapat digunakan kerana kurangnya laluan ekonomi ke monosilane dan kerana masalah pemprosesan dalam langkah pemendapan [13.5]. Walau bagaimanapun, dengan perkembangan terkini laluan ekonomi ke silana kemurnian tinggi dan kejayaan operasi kilang berskala besar, teknologi ini telah menarik perhatian industri semikonduktor, yang memerlukan silikon dengan kemurnian yang lebih tinggi. Dalam proses monosilana industri semasa, serbuk magnesium dan MG-Si dipanaskan hingga 500∘C di bawah atmosfera hidrogen untuk mensintesis silisida magenesium (Mg2Si), yang kemudian dibuat untuk bertindak balas dengan amonium klorida (NH4Cl) dalam ammonia cair (NH3) di bawah 0∘C untuk membentuk monosilana (SiH4). Polysilicon dengan kemurnian tinggi kemudian dihasilkan melalui pirolisis monosilane pada filamen polysilicon yang dipanaskan secara resisten pada 700-800∘C. Dalam proses penghasilan monosilana, sebahagian besar kotoran boron dikeluarkan dari silan melalui tindak balas kimia dengan NH3. Kandungan aboron 0,01-0,02 ppba dalam polisilikon telah dicapai dengan menggunakan proses amonosilane. Kepekatan ini sangat rendah berbanding dengan yang diperhatikan dalam polisilikon yang dibuat dari trichlorosilane. Lebih-lebih lagi, polysilicon yang dihasilkan kurang tercemar dengan logam yang diambil melalui proses pengangkutan kimia kerana penguraian monosilana tidak menyebabkan masalah kakisan. Proses yang sangat berbeza, yang menggunakan penguraian monosilana dalam reaktor pemendapan katil afluid untuk menghasilkan polisilikon berbutir bebas, telah dikembangkan [13.5]. Zarah-zarah biji silikon kecil dibubarkan dalam campuran hidrogen amonosilana, dan polisilikon didepositkan untuk membentuk zarah-zarah sfera bebas yang rata-rata berdiameter 700 μm dengan taburan ukuran 100–1500 μm. Benih dengan bendalir awalnya dibuat dengan mengisar SG-Si di kilang aball atau tukul dan mencuci produk dengan asid, hidrogen peroksida dan air. Proses ini memakan masa dan mahal, dan cenderung untuk memasukkan kekotoran yang tidak diingini ke dalam sistem melalui penggiling logam. Walau bagaimanapun, dalam kaedah baru, zarah SG-Si yang besar saling menembakkan satu sama lain oleh aliran gas berkelajuan tinggi menyebabkan mereka memecah menjadi zarah-zarah dengan ukuran yang sesuai untuk tempat tidur yang bocor. Proses ini tidak memperkenalkan bahan asing dan tidak memerlukan pencucian. Oleh kerana luas permukaan polysilicon berbutir, reaktor bedak bendalir jauh lebih cekap daripada reaktor batang jenis Siemens tradisional. Kualiti polysilicon bed-fluidized telah terbukti setara dengan polisilikon yang dihasilkan dengan kaedah Siemens yang lebih konvensional. Lebih-lebih lagi, polisilikon berbutir dalam bentuk aliran bebas dan ketumpatan pukal yang tinggi membolehkan penanam kristal memperoleh hasil maksimal dari setiap proses pengeluaran. Maksudnya, dalam proses pertumbuhan kristal Czochralski (lihat bahagian berikut), keran dapat diisi dengan cepat dan mudah ke beban seragam yang biasanya melebihi potongan polysilicon yang disusun secara rawak yang dihasilkan oleh kaedah Siemens. Sekiranya kita juga mempertimbangkan potensi teknik untuk berpindah dari operasi batch ke tarikan berterusan (dibahas kemudian), kita dapat melihat bahawa butiran polysilicon yang mengalir bebas dapat memberikan laluan yang menguntungkan dari umpan auniform menjadi lebur keadaan asteady. Produk ini nampaknya merupakan bahan permulaan yang sangat menjanjikan pertumbuhan kristal silikon. Prinsip pertumbuhan kristal tunggal dengan (akaedah zon terapung dan (b) Kaedah Czochralski. (Selepas [13.1]) Dianggarkan sekitar 95%dari semua silikon kristal tunggal dihasilkan dengan kaedah CZ dan selebihnya terutamanya dengan kaedah FZ. Industri semikonduktor silikon memerlukan kemurnian tinggi dan kepekatan minimum kecacatan pada kristal silikon mereka untuk mengoptimumkan hasil pembuatan peranti dan prestasi operasi. Keperluan ini menjadi semakin ketat kerana teknologi berubah dari LSI menjadi VLSI ∕ ULSI dan kemudian SOC. Selain kualiti atau kesempurnaan kristal silikon, diameter kristal juga terus meningkat untuk memenuhi permintaan pengeluar peranti. Oleh kerana cip mikroelektronik dihasilkan melalui asistem kumpulan, diameter wafer silikon yang digunakan untuk fabrikasi peranti secara signifikan mempengaruhi produktiviti (seperti yang ditunjukkan dalam Gambar.13.2), dan seterusnya kos pengeluaran. Pada bahagian berikut, pertama-tama kita membincangkan kaedah FZ dan kemudian beralih ke kaedah CZ. Yang terakhir akan dibincangkan dengan lebih terperinci kerana kepentingannya yang sangat tinggi untuk industri mikroelektronik. Kaedah FZ berasal dari peleburan zon, yang digunakan untuk memperbaiki aloi binari [13.6] dan dicipta olehTheuerer[13.7]. Kereaktifan silikon cair dengan bahan yang digunakan untuk wadah menyebabkan pengembangan kaedah FZ [13.8], yang membenarkan penghabluran silikon tanpa memerlukan sebarang kontak dengan bahan yang boleh dilancarkan, yang diperlukan untuk dapat menumbuhkan kristal dari kemurnian semikonduktor yang diperlukan. Dalam proses FZ, batang apolysilicon diubah menjadi ingot kristal tunggal dengan melewati zon amolten yang dipanaskan oleh gegelung mata aneedle dari satu hujung batang ke ujung yang lain, seperti yang ditunjukkan pada Gambar.13.3a. Pertama, hujung batang polisilikon dihubungi dan menyatu dengan kristal aseed dengan orientasi kristal yang dikehendaki. Proses ini dipanggilpenyemaian. Zon lebur benih dilalui melalui batang polisilikon dengan secara serentak menggerakkan biji kristal tunggal ke bawah batang. Apabila zon lebur silikon padat, polisilikon diubah menjadi silikon kristal tunggal dengan bantuan kristal biji. Semasa zon bergerak di sepanjang batang polisilikon, silikon kristal tunggal membeku di hujungnya dan tumbuh sebagai lanjutan kristal biji. Topografi sinar-X biji, leher dan bahagian kerucut silikon zon terapung. (Dengan hormat Dr. T. Abe) Sistem sokongan untuk kristal silikon zon terapung. (Selepas [13.9]) Untuk mendapatkan kristal tunggal silikon jenis-n atau p dari daya tahan yang diperlukan, sama ada polisilikon atau kristal yang tumbuh mesti didoping dengan kekotoran penderma atau akseptor yang sesuai. Untuk pertumbuhan silikon FZ, walaupun beberapa teknik doping telah dicuba, kristal biasanya didoping dengan meniup gas pemakai seperti fosfin (PH3) untuk silikon atau diborane jenis-n (B2H6) untuk silikon jenis p ke zon lebur. Gas dopan biasanya dicairkan dengan gas acarrier, seperti argon. Kelebihan besar kaedah ini ialah pengeluar kristal silikon tidak perlu menyimpan sumber polisilikon dengan daya tahan yang berbeza. Penggunaan NTD hampir secara eksklusif terhad kepada kristal FZ kerana kesuciannya lebih tinggi berbanding dengan kristal CZ. Semasa teknik NTD diterapkan pada kristal silikon CZ, didapati bahawa pembentukan penderma oksigen semasa proses penyepuhlindapan setelah penyinaran mengubah ketahanan dari yang diharapkan, walaupun homogenitas penderma fosforus dicapai [13.11]. NTD mempunyai kekurangan tambahan bahawa tidak ada proses yang tersedia untuk dopan jenis p dan jangka masa penyinaran yang terlalu lama diperlukan untuk daya tahan rendah (dalam lingkungan 1-10 Ω cm). Semasa pertumbuhan kristal FZ, silikon lebur tidak bersentuhan dengan bahan lain selain gas ambien di ruang pertumbuhan. Oleh itu, kristal silikon FZ secara semula jadi dibezakan oleh kesuciannya yang lebih tinggi berbanding dengan kristal aCZ yang ditanam dari lebur - yang melibatkan hubungan dengan pelindung aquartz. Kenalan ini menimbulkan kepekatan pengotor oksigen yang tinggi sekitar 1018atom ∕ cm3dalam kristal CZ, sementara silikon FZ mengandungi kurang dari 1016atom ∕ cm3. Ketulenan yang lebih tinggi ini membolehkan silikon FZ mencapai daya tahan tinggi yang tidak dapat diperoleh dengan menggunakan silikon CZ. Sebilangan besar silikon FZ yang digunakan mempunyai ketahanan antara 10 dan 200 Ω cm, sementara silikon CZ biasanya disiapkan untuk daya tahan 50 Ω cm atau kurang kerana pencemaran dari wadah kuarza. Oleh itu, silikon FZ digunakan terutamanya untuk membuat peranti kuasa semikonduktor yang menyokong voltan terbalik melebihi 750-1000 V. Pertumbuhan kristal dengan kemurnian tinggi dan ciri doping ketepatan NTD FZ-Si juga menyebabkan penggunaannya dalam pengesan inframerah [13.12], sebagai contoh. Walau bagaimanapun, jika kita mempertimbangkan kekuatan mekanikal, sudah bertahun-tahun diakui bahawa silikon FZ, yang mengandungi lebih sedikit kekotoran oksigen daripada silikon CZ, secara mekanik lebih lemah dan lebih terdedah kepada tekanan haba semasa pembuatan peranti [13.13,13.14]. Pemprosesan wafer silikon pada suhu tinggi semasa pembuatan alat elektronik sering menghasilkan tekanan haba yang mencukupi untuk menjana tergelincir tergelincir dan melengkung. Kesan-kesan ini membawa kepada kehilangan hasil kerana persimpangan yang bocor, kecacatan dielektrik, dan jangka hayat yang berkurang, serta penurunan hasil fotolitografi kerana penurunan kerataan wafer. Kehilangan kerataan geometri kerana melengkung boleh menjadi sangat teruk sehingga wafer tidak diproses lebih jauh. Oleh kerana itu, wafer silikon CZ telah digunakan dengan lebih meluas dalam pembuatan peranti IC daripada yang dimiliki wafer FZ. Perbezaan kestabilan mekanikal terhadap tekanan terma adalah sebab utama mengapa kristal silikon CZ digunakan secara eksklusif untuk pembuatan IC yang memerlukan sejumlah besar langkah proses termal. Untuk mengatasi kekurangan silikon FZ ini, pertumbuhan kristal silikon FZ dengan kekotoran doping seperti oksigen [13.15] dan nitrogen [13.16] telah dicuba. Didapati bahawa doping kristal silikon FZ dengan oksigen atau nitrogen pada kepekatanataumasing-masing, menghasilkan peningkatan kekuatan mekanikal yang luar biasa. Kaedah ini dinamakan J. Czochralski, yang menubuhkan teknik makan untuk menentukan halaju kristalisasi logam [13.17]. Walau bagaimanapun, kaedah penarikan sebenar yang telah banyak digunakan untuk pertumbuhan kristal tunggal dikembangkan olehTekakdanSedikit[13.18], yang mengubah prinsip asas Czochralski. Mereka adalah yang pertama berjaya mengembangkan kristal tunggal germanium, panjang 8 inci dan diameter 0,75 inci, pada tahun 1950. Mereka kemudian merancang alat lain untuk pertumbuhan silikon pada suhu yang lebih tinggi. Walaupun proses pengeluaran asas untuk silikon kristal tunggal sedikit berubah sejak dipelopori oleh Teal dan rakan sekerja, kristal silikon berdiameter besar (hingga 400 mm) dengan tahap kesempurnaan yang tinggi yang memenuhi peranti canggih permintaan telah berkembang dengan memasukkan teknik Dash dan inovasi teknologi berturut-turut ke dalam peralatan. Usaha penyelidikan dan pengembangan hari ini mengenai kristal silikon diarahkan untuk mencapai keseragaman mikroskopik sifat kristal seperti ketahanan dan kepekatan kekotoran dan mikrodefek, serta kawalan mikroskopiknya, yang akan dibincangkan di tempat lain dalam Buku Panduan ini. 1. Potongan polysilicon atau biji-bijian diletakkan di dalam wadah aquartz dan dicairkan pada suhu yang lebih tinggi daripada titik lebur silikon (1420∘C) dalam gas ambien lengai. 2. Cairan disimpan pada suhu tinggi untuk sementara waktu untuk memastikan lebur lengkap dan penyingkiran gelembung kecil, yang boleh menyebabkan kekosongan atau kecacatan kristal negatif, dari lebur. 3. Kristal Aseed dengan orientasi kristal yang dikehendaki dicelupkan ke dalam lebur sehingga ia mula mencair sendiri. Benih kemudian ditarik dari lebur sehingga leher dibentuk dengan mengurangkan diameter secara beransur-ansur; ini adalah langkah yang paling halus. Sepanjang keseluruhan proses pertumbuhan kristal, gas lengai (biasanya argon) mengalir ke bawah melalui ruang penarik untuk mengeluarkan produk tindak balas seperti SiO dan CO. 4. Dengan secara beransur-ansur meningkatkan diameter kristal, bahagian kerucut dan bahu tumbuh. Diameter ditingkatkan hingga diameter sasaran dengan menurunkan laju penarik dan ∕ atau suhu lebur. 5. Akhirnya, bahagian badan silinder dengan diameter aconstant ditanam dengan mengawal kadar penarik dan suhu lebur sambil mengimbangi penurunan tahap lebur ketika kristal tumbuh. Laju penarik pada umumnya dikurangkan ke arah hujung kristal yang semakin meningkat, terutamanya disebabkan oleh peningkatan radiasi haba dari dinding yang dapat dilancarkan ketika tahap lebur turun dan memaparkan dinding yang lebih kuat untuk kristal yang tumbuh. Menjelang akhir proses pertumbuhan, tetapi sebelum wadah itu benar-benar dikeringkan dari silikon lebur, diameter kristal mesti dikurangkan secara beransur-ansur untuk membentuk kerucut akhir untuk meminimumkan kejutan terma, yang dapat menyebabkan tergelincir tergelincir di ujung ekor. Apabila diameternya menjadi cukup kecil, kristal dapat dipisahkan dari lebur tanpa penghasilan terkehel. Pandangan skematik sistem pengembangan kristal silikon Czochralski khas. (Selepas [13.1]) Bahagian hujung kristal silikon Czochralski yang telah tumbuh Jongkong silikon Czochralski yang tumbuh besar dengan diameter 400 mm dan panjang 1800 mm. (Dengan hormat dari Super Silicon Crystal Research Institute Corporation, Jepun) Persekitaran termal semasa pertumbuhan kristal Czochralski pada peringkat awal dan akhir.Anak panahmenunjukkan arah aliran aliran haba. (Selepas [13.19]) Juga, pengagihan anonuniform kedua-dua kecacatan kristal dan kekotoran berlaku di bahagian melintang wafer aflat yang disediakan dari cair silikon kristal aCZ yang dikristal atau dipadatkan berturut-turut pada antara muka kristal-lebur, yang umumnya melengkung dalam proses pertumbuhan kristal CZ. Ketidaksamaan seperti itu dapat diperhatikan sebagaipukulan, yang dibincangkan kemudian. Sifat semikonduktor silikon yang digunakan dalam alat elektronik sangat sensitif terhadap kekotoran. Oleh kerana kepekaan ini, sifat elektrik elektronik silikon dapat dikawal dengan tepat dengan menambahkan jumlah dopan yang sedikit. Sebagai tambahan kepada kepekaan dopan ini, pencemaran oleh kekotoran (terutamanya logam peralihan) memberi kesan negatif terhadap sifat silikon dan mengakibatkan penurunan prestasi peranti yang serius. Lebih-lebih lagi, oksigen dimasukkan pada tahap puluhan atom per juta ke dalam kristal silikon CZ kerana tindak balas antara lebur silikon dan wadah kuarza. Tidak kira berapa banyak oksigen dalam kristal, ciri-ciri kristal silikon sangat dipengaruhi oleh kepekatan dan tingkah laku oksigen [13.21]. Selain itu, karbon juga dimasukkan ke dalam kristal silikon CZ sama ada dari bahan mentah polisilikon atau semasa proses pertumbuhan, kerana bahagian grafit yang digunakan dalam peralatan penarik CZ. Walaupun kepekatan karbon dalam kristal silikon CZ komersial biasanya kurang dari 0.1 ppma, karbon adalah kekotoran yang sangat mempengaruhi kelakuan oksigen [13.22,13.23]. Juga, kristal silikon CZ nitrogen-doped [13.24,13.25] baru-baru ini menarik banyak perhatian kerana kualiti kristal mikroskopiknya yang tinggi, yang mungkin memenuhi syarat untuk alat elektronik canggih [13.26,13.27]. Semasa penghabluran dari peleburan, pelbagai kekotoran (termasuk dopan) yang terkandung dalam lebur dimasukkan ke dalam kristal yang sedang tumbuh. Kepekatan kotoran fasa pepejal umumnya berbeza dengan fasa cecair kerana fenomena yang dikenali sebagaipengasingan. Tingkah laku pengasingan keseimbangan yang berkaitan dengan pemadatan sistem multikomponen dapat ditentukan dari gambarajah fasa sistem abiner yang sesuai denganzat terlarut(kekotoran) dan apelarut(bahan inang) sebagai komponen. Oleh itu, jelas bahawa variasi longitudinal amakroskopik pada tahap pengotor, yang menyebabkan avariasi dalam resistiviti kerana variasi kepekatan dopan, adalah wujud dalam proses pertumbuhan kumpulan CZ; ini disebabkan oleh fenomena pemisahan. Lebih-lebih lagi, taburan kekotoran membujur dipengaruhi oleh perubahan magnitud dan sifat perolakan lebur yang berlaku kerana nisbah aspek lebur menurun semasa pertumbuhan kristal. Pertumbuhan pertumbuhan, yang ditunjukkan oleh etsa kimia, pada batu silikon Czochralski Striasi secara fizikal disebabkan oleh pengasingan kekotoran dan juga titik kecacatan; namun, pemadatan secara praktikal disebabkan oleh turun naik suhu berhampiran antara muka kristal-lebur, yang disebabkan oleh perolakan haba yang tidak stabil dalam putaran lebur dan kristal dalam persekitaran terma yang tidak simetri. Selain itu, getaran mekanikal kerana mekanisme kawalan penarik yang buruk pada peralatan pertumbuhan juga boleh menyebabkan turun naik suhu. Skema ilustrasi keratan rentas kristal Czochralski yang mengandungi antara muka cair kristal-lebur dan wafer planar yang dipotong menjadi bahagian yang berbeza. (Selepas [13.1]) Untuk mendapatkan ketahanan yang diinginkan, sejumlah dopan (sama ada atom penderma atau akseptor) ditambahkan ke lebur asilicon mengikut hubungan ketahanan-kepekatan. Adalah menjadi kebiasaan untuk menambahkan dopan dalam bentuk zarah silikon yang sangat doped atau potongan sekitar 0,01 Ω cm resistiviti, yang disebut lekapan dopan, kerana jumlah dopan tulen yang diperlukan tidak terkawal kecil, kecuali bahan silikon yang sangat banyak+atau hlm+silikon). 1. Tahap tenaga yang sesuai 2. Keterlarutan tinggi 3. Penyebaran yang sesuai atau rendah 4. Tekanan wap rendah. Penggabungan oksigen dan karbon ke dalam kristal silikon Czochralski. (Selepas [13.1]) 1. Diameter besar 2. Ketumpatan kecacatan rendah atau terkawal 3. Kecerunan ketahanan radial yang seragam dan rendah 4. Kepekatan oksigen awal yang optimum dan pemendakannya. Aliran perolakan lebur di dalam peluru dapat mempengaruhi kualiti kristal silikon CZ Khususnya, pergolakan pertumbuhan yang tidak baik disebabkan oleh perolakan lebur yang tidak stabil yang mengakibatkan turun naik suhu pada antara muka pertumbuhan. Keupayaan medan amagnetik untuk menghalang perolakan haba dalam cecair yang mengalir elektrik mula-mula digunakan pada pertumbuhan kristal antimonida indium melalui teknik perahu mendatar [13.28] dan teknik pencairan zon mendatar [13.29]. Melalui penyiasatan ini, disahkan bahawa medan amagnetik dengan kekuatan yang mencukupi dapat menekan turun naik suhu yang menyertai perolakan lebur, dan dapat secara dramatis mengurangi pertumbuhan pertumbuhan. Pengaruh medan magnet pada rintangan pertumbuhan dijelaskan oleh kemampuannya untuk mengurangkan perolakan terma bergelombang dari peleburan dan seterusnya menurunkan turun naik suhu pada antara muka kristal-lebur. Peredaman aliran bendalir yang disebabkan oleh medan magnet disebabkan oleh daya magnetomotif yang diinduksi ketika aliran adalah ortogonal ke garis fluks magnetik, yang mengakibatkan peningkatan kelikatan kinematik efektif dari lelehan pengalir. Pertumbuhan kristal silikon dengan kaedah medan magnet yang digunakan CZ (MCZ) dilaporkan buat pertama kalinya pada tahun 1980 [13.30]. Mula-mula MCZ bertujuan untuk pertumbuhan kristal silikon CZ yang mengandungi kepekatan oksigen rendah dan oleh itu mempunyai daya tahan tinggi dengan variasi radial rendah. Dengan kata lain, silikon MCZ diharapkan dapat menggantikan silikon FZ yang hampir secara eksklusif digunakan untuk fabrikasi peranti kuasa. Sejak itu, pelbagai konfigurasi medan magnet, dari segi arah medan magnet (mendatar atau menegak) dan jenis magnet yang digunakan (konduktif normal atau superkonduktif), telah dikembangkan [13.31]. Silikon MCZ yang dihasilkan dengan pelbagai kepekatan oksigen yang dikehendaki (dari rendah ke tinggi) sangat menarik untuk aplikasi peranti yang berbeza. Nilai silikon MCZ terletak pada kualiti tinggi dan kemampuannya untuk mengawal kepekatan oksigen dalam jarak jauh, yang tidak dapat dicapai dengan menggunakan kaedah CZ konvensional [13.32], serta peningkatan kadar pertumbuhannya [13.33]. Mengenai kualiti kristal, tidak ada keraguan bahawa kaedah MCZ menyediakan kristal silikon yang paling baik untuk industri peranti semikonduktor. Kos pengeluaran silikon MCZ mungkin lebih tinggi daripada silikon CZ konvensional kerana kaedah MCZ menggunakan lebih banyak tenaga elektrik dan memerlukan peralatan dan ruang operasi tambahan untuk elektromagnet; namun, dengan mengambil kira kadar pertumbuhan MCZ yang lebih tinggi, dan apabila magnet superkonduktif yang memerlukan ruang yang lebih kecil dan menggunakan tenaga elektrik yang lebih sedikit dibandingkan dengan magnet konduktif digunakan, kos pengeluaran kristal silikon MCZ mungkin menjadi sebanding dengan kristal silikon CZ konvensional. Di samping itu, peningkatan kualiti kristal silikon MCZ dapat meningkatkan hasil pengeluaran dan menurunkan kos pengeluaran. Kos pengeluaran kristal sangat bergantung pada kos bahan, khususnya kos yang digunakan untuk kristal kuarza. Dalam proses CZ konvensional, disebut aproses kumpulan, acrystal ditarik dari satu cas wadah, dan wadah kuarza hanya digunakan sekali dan kemudian dibuang. Ini kerana sebilangan kecil silikon yang tersisa memecahkan pelindung semasa ia menyejuk dari suhu tinggi semasa setiap pertumbuhan dijalankan. Onestrategi untuk mengisi semula wadah akuartz dengan lebur secara ekonomi adalah menambahkan makanan secara berterusan semasa kristal ditanam dan dengan demikian mengekalkan lebur pada isipadu. Sebagai tambahan untuk menjimatkan kos, kaedah Czochralski (CCZ) pengisian berterusan menyediakan persekitaran yang ideal untuk pertumbuhan kristal silikon. Seperti yang telah disebutkan, banyak ketidakhomogenan dalam kristal yang ditanam oleh proses kumpulan CZ konvensional adalah hasil tidak langsung dari kinetik yang tidak stabil yang timbul dari perubahan jumlah lebur semasa pertumbuhan kristal. Kaedah CCZ bertujuan bukan sahaja untuk mengurangkan kos pengeluaran tetapi juga menumbuhkan kristal dalam keadaan stabil. Dengan mengekalkan isipadu lebur pada tahap aconstant, keadaan aliran terma dan aliran lebur dapat dicapai (lihat Gambar.13.9, yang menunjukkan perubahan persekitaran termal semasa pertumbuhan CZ konvensional). Ilustrasi skematik kaedah Czochralski pengisian berterusan. (Selepas [13.34]) Kaedah CCZ pastinya dapat menyelesaikan sebahagian besar masalah yang berkaitan dengan inhomogeneities dalam kristal yang ditanam dengan kaedah CZ konvensional. Lebih-lebih lagi, gabungan MCZ dan CCZ (CZ berterusan diterapkan medan magnet (MCCZ) kaedah) diharapkan dapat memberikan kaedah pertumbuhan kristal utama, memberikan kristal silikon yang ideal untuk pelbagai aplikasi mikroelektronik [13.1]. Memang, ia telah digunakan untuk menumbuhkan kristal silikon berkualiti tinggi yang ditujukan untuk peranti mikroelektronik [13.35]. Walau bagaimanapun, perlu ditekankan bahawa sejarah termal yang berlainan dari bahagian kristal yang berlainan (dari benih hingga ujung ekor, seperti yang ditunjukkan pada Gambar.13.9) mesti dipertimbangkan walaupun kristal ditanam dengan kaedah pertumbuhan yang ideal. Untuk menghomogenkan kristal yang tumbuh atau untuk mendapatkan keseragaman paksi dalam sejarah termal, beberapa bentuk rawatan pasca, seperti penyepuhlindapan suhu tinggi [13.36], diperlukan untuk kristal. Seperti disebutkan sebelumnya, proses leher Dash (yang tumbuh di leher berdiameter 3-5 mm, Gambar.13.7) adalah langkah akritik semasa pertumbuhan kristal CZ kerana menghilangkan kehelan dewasa. Teknik ini telah menjadi standard industri selama lebih dari 40 tahun. Walau bagaimanapun, permintaan baru-baru ini untuk diameter kristal besar (& gt; 300 mm, berat lebih dari 300 kg) telah menyebabkan perlunya leher berdiameter lebih besar yang tidak membawa kehelan ke dalam kristal yang tumbuh, kerana leher athin berdiameter 3-5 mm tidak dapat menyokong kristal sebegitu besar. Kristal silikon Czochralski tanpa dislokasi diameter 200 mm tumbuh tanpa proses leher Dash. (a)Seluruh badan, (b) biji dan kon. (Dengan hormat Prof K. Hoshikawa) 13.1F. Shimura:Teknologi Kristal Silikon Semikonduktor(Akademik, New York 1988)Cendekiawan Google Dash 13.2WC: J. Appl. Fiz.29, 736 (1958)CrossRefCendekiawan Google 13.3K.Takada, H.Yamagishi, H.Minami, M.Imai: Dalam:Silikon Semikonduktor(Persatuan Elektrokimia, Pennington 1998) hlm.376Cendekiawan Google 13.4JRMcCormic: Dalam:Silikon Semikonduktor(Persatuan Elektrokimia, Pennington 1986) hlm.43Cendekiawan Google 13.5PA Taylor: Solid State Technol.Julai, 53 (1987)Cendekiawan Google 13.6WG Pfann: Trans. Am. Inst. Min. Metall. Eng.194, 747 (1952)Cendekiawan Google 13.7CHTheuerer: Paten AS 3060123 (1962)Cendekiawan Google 13.8PH Keck, MJE Golay: Phys. Pendeta89, 1297 (1953)CrossRefCendekiawan Google 13.9W. Keller, A. Mühlbauer:Silikon Zon Terapung(Marcel Dekker, New York 1981)Cendekiawan Google 13.10JM Meese:Transmutasi Neutron Doping dalam Semikonduktor(Plenum, New York 1979)CrossRefCendekiawan Google 13.11HMLiaw, CJVarker: Dalam:Silikon Semikonduktor(Persatuan Elektrokimia, Pennington 1977) hlm.116Cendekiawan Google 13.12ELKern, LSYaggy, JABarker: Dalam:Silikon Semikonduktor(Persatuan Elektrokimia, Pennington 1977) hlm.52Cendekiawan Google 13.13SM Hu: Aplikasi. Fiz. Lett.31, 53 (1977)CrossRefCendekiawan Google 13.14K. Sumino, H. Harada, I. Yonenaga: Jpn. J. Appl. Fiz.19, L49 (1980)CrossRefCendekiawan Google 13.15K. Sumino, I. Yonenaga, A. Yusa: Jpn. J. Appl. Fiz.19, L763 (1980)CrossRefCendekiawan Google 13.16T.Abe, K.Kikuchi, S.Shirai: Dalam:Silikon Semikonduktor(Persatuan Elektrokimia, Pennington 1981) hlm.54Cendekiawan Google 13.17J. Czochralski: Z. Phys. Chem.92, 219 (1918)Cendekiawan Google 13.18GK Teal, JB Little: Phys. Pendeta78, 647 (1950)Cendekiawan Google 13.19W. Zulehner, D. Huber: Dalam:Kristal 8: Silicon, Chemical Etching(Springer, Berlin, Heidelberg 1982) hlm. 1Cendekiawan Google 13.20H. Tsuya, F. Shimura, K. Ogawa, T. Kawamura: J. Electrochem. Soc.129, 374 (1982)CrossRefCendekiawan Google 13.21F. Shimura (Ed.):Oksigen dalam Silikon(Akademik, New York 1994)Cendekiawan Google 13.22S. Kishino, Y. Matsushita, M. Kanamori: Appl. Fiz. Lett.35, 213 (1979)CrossRefCendekiawan Google 13.23F. Shimura: J. Appl. Fiz.59, 3251 (1986)CrossRefCendekiawan Google 13.24HD Chiou, J. Moody, R. Sandfort, F. Shimura: Teknologi sains VLSI, Proc. Int 2hb. Symp. Integrasi Skala Sangat Besar. (Persatuan Elektrokimia, Pennington 1984) h. 208Cendekiawan Google 13.25F. Shimura, RS Hocket: Aplikasi. Fiz. Lett.48, 224 (1986)CrossRefCendekiawan Google 13.26A.Huber, M.Kapser, J.Grabmeier, U. Lambert, WvAmmon, R.Pech: Dalam:Silikon Semikonduktor(Persatuan Elektrokimia, Pennington 2002) hlm.280Cendekiawan Google 13.27GARozgonyi: Dalam:Silikon Semikonduktor(Persatuan Elektrokimia, Pennington 2002) hlm.149Cendekiawan Google 13.28HP Utech, MC Flemings: J. Appl. Fiz.37, 2021 (1966)CrossRefCendekiawan Google 13.29HA Chedzey, DT Hurtle: Alam Semula jadi210, 933 (1966)CrossRefCendekiawan Google 13.30K.Hoshi, T.Suzuki, Y.Okubo, N.Isawa: Samb. Abstr. Elektrokem. Soc. Mesyuarat ke-157. (Persatuan Elektrokimia, Pennington 1980) hlm.811Cendekiawan Google 13.31M.Ohwa, T.Higuchi, E.Toji, M.Watanabe, K.Homma, S.Takasu: Dalam:Silikon Semikonduktor(Persatuan Elektrokimia, Pennington 1986) hlm.117Cendekiawan Google 13.32MFutagami, K.Hoshi, N.Isawa, T.Suzuki, Y.Okubo, Y.Kato, Y.Okamoto: Dalam:Silikon Semikonduktor(Persatuan Elektrokimia, Pennington 1986) hlm.939Cendekiawan Google 13.33T.Suzuki, N.Isawa, K.Hoshi, Y.Kato, Y.Okubo: Dalam:Silikon Semikonduktor(Persatuan Elektrokimia, Pennington 1986) hlm.142Cendekiawan Google 13.34W.Zulehner: Dalam:Silikon Semikonduktor(Persatuan Elektrokimia, Pennington 1990) hlm.30Cendekiawan Google 13.35Y.Arai, M.Kida, N.Ono, K.Abe, N.Machida, H.Futuya, K.Sahira: Dalam:Silikon Semikonduktor(Persatuan Elektrokimia, Pennington 1994) hlm.180Cendekiawan Google 13.36F. Shimura: Dalam:Sains dan Teknologi VLSI(Persatuan Elektrokimia, Pennington 1982) h. 17Cendekiawan Google 13.37S.Chandrasekhar, KMKim: Dalam:Silikon Semikonduktor(Persatuan Elektrokimia, Pennington 1998) hlm.411Cendekiawan Google 13.38K. Hoshikawa, X. Huang, T. Taishi, T. Kajigaya, T. Iino: Jpn. J. Appl. Fiz.38, L1369 (1999)CrossRefCendekiawan Google 13.39KM Kim, P. Smetana: J. Cryst. Pertumbuhan100, 527 (1989)CrossRefCendekiawan Google13.1Gambaran keseluruhan


13.2Bahan Permulaan
13.2.1Silikon Gred Metalurgi
Bahan permulaan untuk kristal tunggal silikon dengan ketulenan tinggi adalah silika (SiO2). Langkah pertama dalam pembuatan silikon adalah pencairan dan pengurangan silika. Ini dicapai dengan mencampurkan silika dan karbon dalam bentuk arang batu, coke atau serpihan kayu dan memanaskan campuran ke suhu tinggi dalam relau busur elektrod yang terendam. Pengurangan karbotermik silika ini menghasilkan silikon bersatu13.2.2Silikon polikristalin
Sebatian Kimia Pertengahan
Hidroklorinasi Silikon
Trichlorosilane disintesis dengan memanaskan MG-Si serbuk pada sekitar 300∘C dalam reaktor katil terfluid. Iaitu, MG-Si diubah menjadi SiHCl3mengikut reaksi berikutPenyulingan dan Penguraian Trichlorosilane
Penyulingan telah digunakan secara meluas untuk membersihkan trichlorosilane. Trichlorosilane, yang mempunyai titik didih rendah (31.8∘C), disuling secara fraksional dari halida yang tidak murni, sehingga menghasilkan kemurnian yang sangat meningkat, dengan kepekatan pengotor aktif elektrik kurang dari 1 ppba. Trichlorosilane dengan kemurnian tinggi kemudian diuapkan, diencerkan dengan hidrogen kemurnian tinggi, dan dimasukkan ke dalam reaktor pemendapan. Di dalam reaktor, batang silikon nipis yang disebut batang langsing yang disokong oleh elektrod grafit tersedia untuk pemendapan permukaan silikon mengikut tindak balasProses Monosilane
Pemendapan Polysilicon Granular
13.3Pertumbuhan Kristal Tunggal
Walaupun pelbagai teknik telah digunakan untuk mengubah polysilicon menjadi kristal silikon tunggal, dua teknik telah mendominasi pengeluarannya untuk elektronik kerana memenuhi syarat industri peranti mikroelektronik. Salah satunya adalah kaedah pencairan azon yang biasa disebutzon terapung (FZkaedah, dan yang lain adalah kaedah menarik secara tradisional disebutCzochralski (CZkaedah, walaupun sebenarnya harus disebutKaedah Teal – Little. Prinsip-prinsip di sebalik kedua kaedah pertumbuhan kristal ini digambarkan dalam Gambar.13.3. Dalam kaedah FZ, zon amolten dilewatkan melalui batang apolysilicon untuk mengubahnya menjadi ingot kristal tunggal; dalam kaedah CZ, satu kristal ditanam dengan menarik dari peleburan yang terkandung dalam wadah aquartz. Dalam kedua kes tersebut,kristal bijimemainkan peranan yang sangat penting dalam mendapatkan satu kristal dengan orientasi kristalografi yang diinginkan.
13.3.1Kaedah Zon Terapung
Kenyataan umum
Garis Besar Proses


Doping
Sifat-sifat FZ-Silicon Crystal
13.3.2Kaedah Czochralski
Kenyataan umum
Garis Besar Proses
Tiga langkah terpenting dalam pertumbuhan kristal CZ ditunjukkan secara skematik dalam Rajah.13.3b. Pada prinsipnya, proses pertumbuhan CZ mirip dengan pertumbuhan FZ: (1) polysilicon lebur, (2) penyemaian dan (3) pertumbuhan. Prosedur penarikan CZ, bagaimanapun, lebih rumit daripada pertumbuhan FZ dan dibezakan dari itu dengan penggunaan wadah aquartz untuk mengandung silikon lebur. Gambar13.6menunjukkan pandangan askemik peralatan pertumbuhan kristal CZ moden yang tipikal. Langkah-langkah penting dalam urutan pertumbuhan kristal silikon CZ sebenar atau standard adalah seperti berikut:
Gambar13.7menunjukkan bahagian hujung biji kristal silikon CZ yang telah tumbuh. Walaupun jagung aseed, yang merupakan wilayah peralihan dari biji ke bahagian silinder, biasanya dibentuk menjadi agak rata untuk alasan ekonomi, bentuk yang lebih tirus mungkin diinginkan dari sudut kualitas acrystal. Bahagian bahu dan sekitarnya tidak boleh digunakan untuk fabrikasi peranti kerana bahagian ini dianggap sebagai kawasan peralihan dalam banyak deria dan ia menunjukkan ciri-ciri kristal yang tidak homogen kerana perubahan keadaan pertumbuhan yang tiba-tiba.
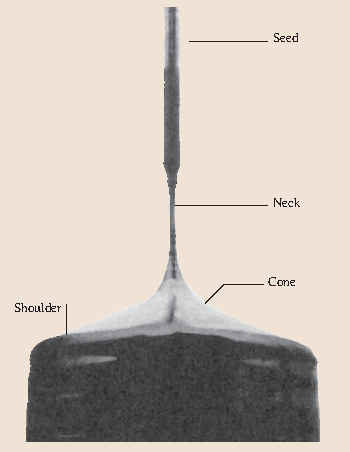

Pengaruh Lokasi Spasial diGrownCrystal
Seperti Rajah.13.9menggambarkan dengan jelas, setiap bahagian kristal aCZ ditanam pada masa yang berbeza dengan keadaan pertumbuhan yang berbeza [13.19]. Oleh itu, penting untuk memahami bahawa setiap bahagian mempunyai set ciri kristal yang berbeza dan sejarah terma yang berbeza kerana kedudukannya yang berbeza sepanjang panjang kristal. Sebagai contoh, bahagian hujung benih mempunyai sejarah termal yang lebih jauh, dari titik lebur 1420 hingga sekitar 400∘C di apuller, sementara bahagian hujung ekor mempunyai riwayat aster dan disejukkan agak cepat dari titik lebur. Pada akhirnya, setiap wafer silikon yang disediakan dari bahagian lain dari kristal agrown dapat menunjukkan ciri-ciri fizik-kimia yang berbeza bergantung pada lokasinya di jongkong. Sebenarnya, telah dilaporkan bahawa tingkah laku pemendakan oksigen menunjukkan ketergantungan lokasi yang paling besar, yang seterusnya mempengaruhi penjanaan kecacatan pukal [13.20].
13.3.3Kekotoran dalam Czochralski Silicon
Ketidaktentuan Kekotoran
Pengasingan
Striasi
Dalam kebanyakan proses pertumbuhan kristal, terdapat peralihan dalam parameter seperti kadar pertumbuhan mikroskopik seketika dan ketebalan lapisan sempadan penyebaran yang menghasilkan variasi dalam pekali pengasingan efektifkeff. Variasi ini menimbulkan ketidaksamaan komposisi mikroskopik dalam bentukpukulanselari dengan antara muka kristal-lebur. Striasi dapat digambarkan dengan mudah dengan beberapa teknik, seperti etsa kimia pilihan dan topografi sinar-x. Gambar13.10menunjukkan lekukan yang ditunjukkan oleh etsa kimia di bahagian bahu bahagian keratan rentas kristal silikon aCZ. Perubahan secara beransur-ansur dalam bentuk antara muka pertumbuhan juga diperhatikan dengan jelas.

Doping
Difusiviti yang tinggi atau tekanan wap yang tinggi menyebabkan penyebaran atau pengewapan dopan yang tidak diingini, yang mengakibatkan operasi peranti yang tidak stabil dan kesukaran dalam mencapai kawalan ketahanan yang tepat. Asolubility yang terlalu kecil menghadkan daya tahan yang boleh diperoleh. Sebagai tambahan kepada kriteria tersebut, sifat kimia (ketoksikan misalnya) mesti dipertimbangkan. Pertimbangan lebih lanjut dari sudut pertumbuhan kristal adalah bahawa dopan mempunyai pekali pengasingan yang dekat dengan kesatuan untuk membuat daya tahan seragam mungkin dari ujung benih hingga ujung ekor jongkong kristal CZ. Oleh itu, fosforus (P) dan boron (B) adalah dopan penderma dan akseptor yang paling biasa digunakan. Untuk n+silikon, di mana atom penderma sangat banyak doping, antimoni (Sb) biasanya digunakan sebagai ganti fosfor kerana difusivasinya yang lebih kecil, walaupun pekali pemisahannya yang kecil dan tekanan wap yang tinggi, yang menyebabkan variasi kepekatan yang besar pada kedua-dua paksi dan arah jejari.Oksigen dan Karbon
Seperti yang ditunjukkan secara skematik dalam Gambar.13.3b dan13.6, aquartz (SiO2) elemen pemanasan pelindung dan grafit digunakan dalam kaedah pertumbuhan kristal CZ-Si. Permukaan salib yang menyentuh lebur silikon secara beransur-ansur dilarutkan kerana tindak balas
13.4Kaedah Pertumbuhan Kristal Baru
Kristal silikon yang digunakan untuk fabrikasi peranti mikroelektronik mesti memenuhi syarat yang ditetapkan oleh pengeluar peranti. Sebagai tambahan kepada keperluan untuk silikonwafer, tuntutan kristalografi berikut menjadi lebih biasa kerana pembuatan peranti mikroelektronik hasil tinggi dan berprestasi tinggi:
Jelas bahawa pengeluar kristal silikon bukan sahaja mesti memenuhi keperluan di atas tetapi juga menghasilkan kristal tersebut secara ekonomi dan dengan hasil pembuatan yang tinggi. Keprihatinan utama penanam kristal silikon adalah kesempurnaan kristalografi dan pembahagian paksi dopan dalam silikon CZ. Untuk mengatasi beberapa masalah dengan kaedah pertumbuhan kristal CZ konvensional, beberapa kaedah pertumbuhan kristal baru telah dikembangkan.13.4.1Pertumbuhan Czochralski denganAppliedMagneticField (MCZ)
13.4.2Kaedah Czochralski Berterusan (CCZ)

13.4.3Kaedah Pertumbuhan Tanpa Leher

Rujukan

















